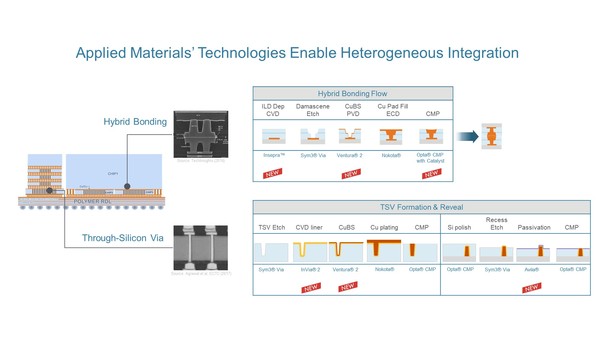 ▲ 이종 접합 칩 제조를 위한 어플라이드 신기술
▲ 이종 접합 칩 제조를 위한 어플라이드 신기술
어플라이드 머티어리얼즈가 하이브리드 본딩과 실리콘관통전극 공법을 사용해 칩렛을 최신 2.5D 및 3D 패키지에 통합하는데 도움이 되는 재료, 기술 및 시스템을 출시했다.
어플라이드 머티어리얼즈(AMAT)는 하이브리드본딩과 실리콘관통전극(TSV)을 통해 이종 접합 칩기술을 향상시키는 어플라이드 신기술을 선보였다고 지난 17일 밝혔다.
이번에 선보인 이종 접합 제조(HI·Heterogeneous Integration) 신기술은 반도체 회사가 다양한 기능, 기술 노드, 크기의 칩렛을 최신 패키지로 결합해 단일 제품처럼 작동하도록 지원한다.
고성능 컴퓨팅, 인공지능(AI) 같은 분야에서 트랜지스터 필요성은 기하급수로 증가하는 반면,기존 2D 스케일링을 통해 트랜지스터를 축소하는 방식은 느리고 더 많은 비용이 소요된다. HI는 반도체 제조업체가 새로운 방식으로 칩의 전력·성능·크기·비용·시장출시기간을 개선하도록 도움을 준다.
칩 투 웨이퍼(chip-to-wafer), 웨이퍼 투 웨이퍼(wafer-to-wafer) 하이브리드 본딩은 직접 구리-구리 결합을 사용해 칩을 연결함으로써 결합된 소자가 단일 제품의 성능을 내도록 한다. 하이브리드 본딩은 현재 가장 발전된 HI 기술로, 더 작은 공간에 더 많은 배선을 집적하고 신호가 이동하는 거리를 줄임으로써 처리량(throughput)과 전력을 개선한다.
TSV는 적층된 칩을 정밀하게 연결해 주는 수직 와이어다. 실리콘에 트렌치를 식각한 다음 절연박막과 금속 와이어로 채우는 방식이다. 많은 로직, 메모리, 특수 칩이 최신2.5D 및 3D 패키지에 통합됨에 따라 TSV 인터커넥트 수가 패키지당 수백 개에서 수천 개로 확장되고 있다. 더 많은 인터커넥트를 통합하고 더 높은 칩 스택을 수용하기 위해 비아를 더 좁고 높게 만들어야 하는데, 이는 증착 균일성을 저하시켜 성능이 저하되고 저항과 전력 소비는 증가시키게 된다.
어플라이드 머티어리얼즈 관계자는 “최신 HI 솔루션은 2.5D 및 3D 구성에서 더 많은 트랜지스터와 배선을 패키징하는 첨단 기술을 발전시킨다“면서“이를 통해 시스템 성능은 높이면서 전력 소비는 줄이고, 크기를 최소화하며, 시장 출시 시간을 단축할 수 있다”고 말했다.
