 ▲ 네패스라웨의 첨단 패키징 신규 Fab 전경
▲ 네패스라웨의 첨단 패키징 신규 Fab 전경네패스의 시스템반도체 패키징 자회사 네패스라웨가 세계 최초로 대면적 PLP(Panel Level Package)를 양산하고 내년 생산캐파를 2배로 늘린다.
네패스라웨는 7일 문승욱 산업통상자원부 장관, 이시종 충북도지사, 고객사 및 협력사 대표 등이 참석한 가운데 충북 괴산에서 청안캠퍼스 PLP라인의 준공식을 개최했다고 밝혔다. 축구장 25개에 달하는 18만6000㎡(5만6000평) 청안캠퍼스 대지 위에 첫번째로 건설된 팹이며, 건축연면적 3만4000㎡(1만400평)로 조성됐다. 투자비는 2,200억원에 달한다.
PLP는 웨이퍼를 자른 칩을 사각형 모양의 패널에 배치후 한꺼번에 패키징해 효율을 향상시킬 수 있다. 네패스라웨는 팬아웃 레벨패키지(FOPLP) 기술을 최초로 상용화했으며 이번에 최초로 대면적인 600mm 공정을 개발했다. 기존 WLP 방식대비 5배의 반도체 칩을 한꺼번에 생산할 수 있는 첨단 패키징 기술이 적용돼 생산효율성 및 가격경쟁력을 확보하게 됐다.
네패스라웨의 FOPLP 생산캐파는 600mm PLP 기준 연간 최대 9만 6천장으로 생산라인이 지난 3분기 고객 인증을 마치고 안정 수율을 확보하여 본격 양산에 진입했다. 또한 고객사 수요에 따라 내년도 생산능력을 2배 이상 확대할 계획이다. 이를 위해 네패스는 2022년 9월까지 1,200억원 규모의 FOPLP 증설을 위한 투자를 완료할 것이라고 공시한 바 있다.
차세대 패키징 라인을 기반으로 네패스는 스마트폰, 자동차, IoT 등 응용처별로 첨단 시스템 반도체에 요구되는 고밀도 패키징 솔루션을 고객의 니즈에 맞춰 제공할 수 있게 됐다. 또한 기존 기술 대비 높은 안정성이 검증돼 향후 첨단 반도체 제조사 중심으로 수요가 늘어나면서 전체 패키지 시장의 기술 점유율에도 변화가 있을 전망이다.
이날 정칠희 네패스 반도체 총괄 회장은 “FOPLP는 소재·부품·장비 등 국내외 파트너들과 오랫동안 협력해 온 결과로 고사양 반도체를 위한 최적의 패키징 솔루션”이라며 “FOPLP 생산 시스템의 세계 표준을 제시한 네패스라웨가 한국의 새로운 후공정 생태계를 구축하는데 디딤돌 역할을 할 것”이라고 전했다.
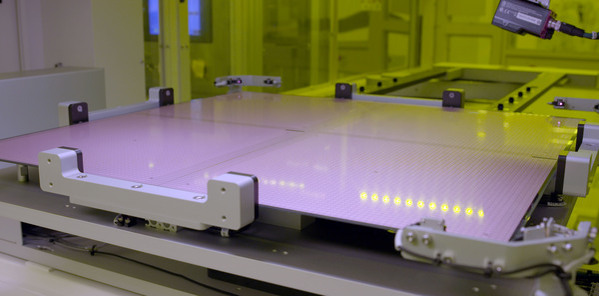 ▲ 네패스라웨의 FOPLP
▲ 네패스라웨의 FOPLP ▲ 준공식에 참석한 (좌부터) 이시종 충북지사와 문승욱 산업부 장관에게 이병구 네패스 회장(가운데)이 설명을 하고 있다.
▲ 준공식에 참석한 (좌부터) 이시종 충북지사와 문승욱 산업부 장관에게 이병구 네패스 회장(가운데)이 설명을 하고 있다.